
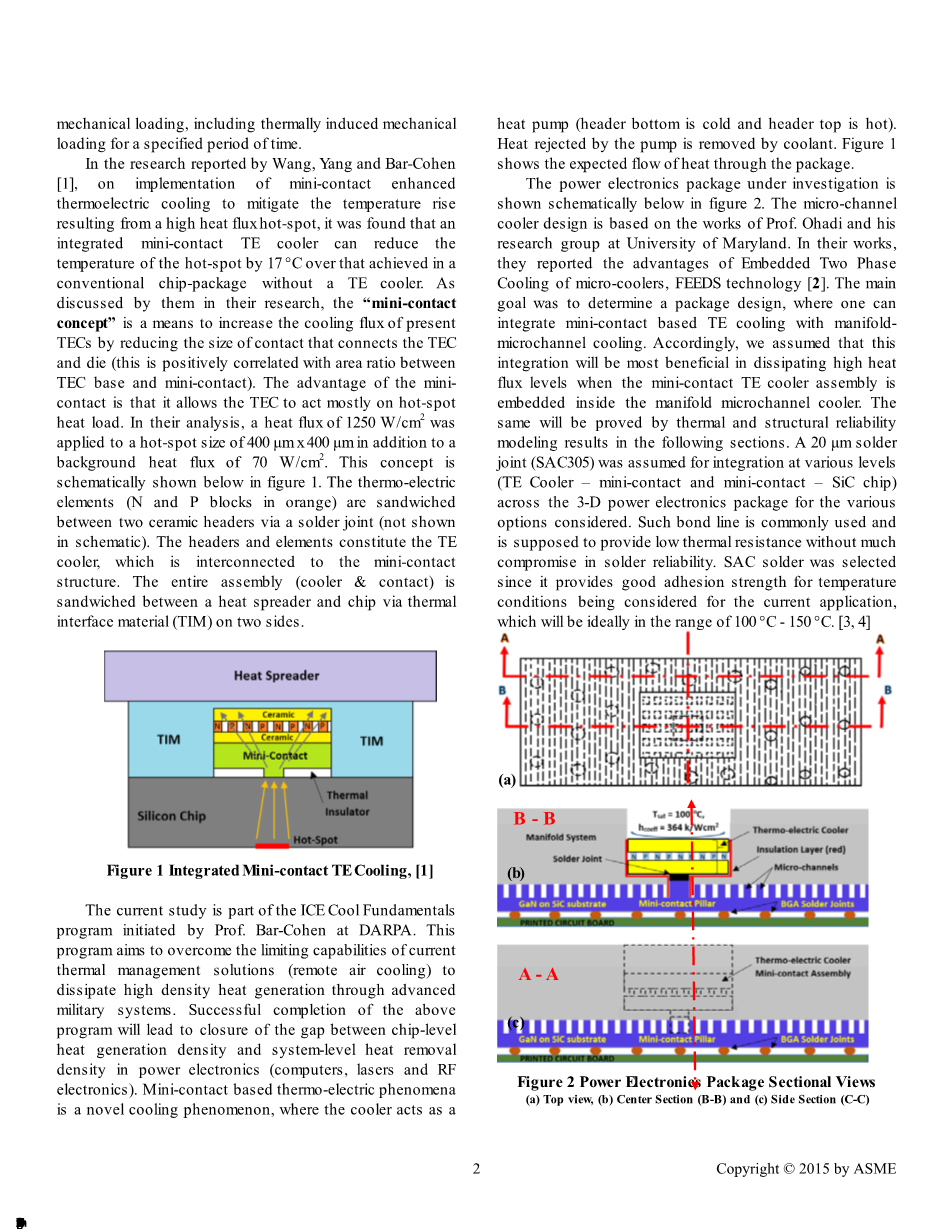
英语原文共 12 页,剩余内容已隐藏,支付完成后下载完整资料
在2015年ASME国际机械工程大会暨展览会论文集
2015年IMECE
11月13日至19日,2015年,德克萨斯州休斯敦
新型3D电子集成的热包装结构可靠性
M.曼诺
马里兰大学克拉克工程学院
机械工程系教授
MD20742,USA
P.麦克拉斯基
马里兰大学克拉克工程学院机械工程系教授
MD20742,USA
S.卡纳
马里兰大学克拉克工程学院
机械工程系教授
,MD20742,USA
M. Ohadi
马里兰大学克拉克工程学院机械工程系教授
MD20742,USA
B.杨
马里兰大学克拉克工程学院机械工程系教授
MD20742,USA
- 巴-科恩
马里兰大学克拉克工程学院
机械工程系教授
MD20742,USA
梗概
功率器件和封装集成度的不断增加带动了先进的电力电子封装解决方案的开发。这项研究将集中在一个数值模拟的方法来设计分析和材料的选择,以改善这些先进的解决方案之一焊点- 热集成电力电子组件的可靠性,旨在消散威盛Mini热点热通量(5千瓦/厘米2) - 联系基于热电(TE)除了由歧管的微通道冷却除去背景热通量(1千瓦/ cm2)的冷却。用于执行结构可靠度建模的方法是一个非线性有限元分析(FEA)的方法。组合的热和机械分析均运行以获得用于集成在TE冷却器与迷你接触并且与碳化硅(SiC)芯片上的微型接触焊点的应力和应变。为了预测SAC305的平均无故障时间(MTTF)在不同的集成度,失败的物理(POF)为基础的方法是使用Engelmaier抯失效模型的应用。
在本文中,我们将讨论的锥形,T形分析的结果,和放样形状做出来的碳化硅,铜和钻石迷你接触。两者的结构设计和材料选择影响热点散热和solderjoint可靠性。碳化硅具有在室温(RT)下一个良好的导热性,然而,随着温度的升高,其热传导率下降,并且这可以在高温应用中的器件性能有不利影响。另一方面,人们可以利用高导电性材料,如铜,金刚石或银 - 金刚石类复合,以保持设备凉爽,从而,提高包的寿命。然而,对于这样的高导电性材料,一种将需要考虑制造复杂的形状,而不在封装的热或可靠性性能的任何折衷的成本。
人们发现,韧性的迷你接触材料将共享与焊料互连的热失配应力,而脆微型接触材料将故障部位转移的TE冷却器内。它被确定微型接触结构锥形靠近其顶部基座和放样(恒定的横截面面积)的芯片(底座)附近将提供最佳的可靠性的效果。讨论了高导电复合材料(银金刚石复合),以提高结构可靠性的应用。
介绍
结构可靠度被定义为一个系统,而不会根据故障执行其预定功能的能力,机械负荷,包括用于在指定的时间段的热引起的机械载荷。
在由B-杨和巴-科恩报道研究[1],实施小型接触的增强热电冷却,以减轻从一个高的热通量热点产生的温度上升,其结果发现,一个集成的微型接触TE冷却器可以通过17癈以上,如果没有的TE冷却器在常规芯片封装实现降低热点的温度如由他们在他们的研究中,搈INI-接触概念讨论?是增加的冷却磁通的装置通过减少连接所述TEC和模具接触的大小本的TECs(这是积极与TEC基和迷你接触之间面积率相关)。微型接触的优点是,它允许将TEC大多作用于热点的热负荷。在他们的分析中1250瓦/ cm 2的热通量施加到400微米times;400微米的一个热点大小除了70W / cm 2的背景热通量。这个概念是示意示于下图1的热电元件(橙色N和P个块)经由焊点(在示意图中未示出)两个陶瓷头之间。页眉和元件构成的TE冷却器,其被互连到微型接触结构。整个组件(散热器及接触)是双方通过热界面材料(TIM)散热器与芯片之间。
目前的研究是在DARPA巴-科恩教授发起的ICE COOL的基础计划的一部分。该计划旨在克服目前的热管理解决方案(远程空气冷却)的限制功能通过先进的军事系统消散高密度发热。上述程序的成功完成将导致在功率电子装置(计算机,激光器和射频电子产品)的芯片级发热密度和系统级排热密度之间的间隙闭合。基于微型接触热电现象是一种新型的冷却现象,其中,冷却器用作热泵(头底部是冷和头顶部是热的)。热由泵拒绝由冷却剂去除。图1示出的热通过封装的预期流量。
受调查的功率电子封装示意性示出在下面图2的微通道散热器的设计是基于Ohadi教授及其在马里兰大学研究小组的作品。在他们的作品,他们的报告微型冷却器的嵌入式两相冷却的优势,饲料技术[2]。的主要目标是确定一个包设计,其中一个可与阀组 - 微通道冷却微型接触基于TE冷却结合。因此,我们假设这个融合将是在当微型接触TE冷却器组件被嵌入在歧微冷却器同样将通过在以下各节热和结构可靠性建模结果证明内消散高热通量水平最有利的。一个20日下午焊点(SAC305)假定为在各级(TE冷却器 - 微型接触和迷你接触 - 碳化硅芯片)集成在整个3-D电力电子封装所考虑的各种选择。这样粘合线是常用并且被认为是提供低热阻无焊料可靠性许多折衷。被选定的SAC焊料,因为它对于被考虑当前应用程序,这将是理想的在100 -150癈癈范围的温度条件下提供了良好的粘合强度。 [3,4
图1集成的Mini-TE接触冷却,[1
图2电力电子封装的剖面图
(一)顶视图,(B)中心组(B-B)和(c)侧部(C-C)
版权所有2015年ASME
上述研究电力电子封装的脆性和韧性材料的组合。预测故障现场位置,并反过来,对于失败的时间段,基于失效可能性的方法被实施。像焊料和迷你接触(铜)的材料在本质上是延展性的,因此,被用于研究失败将如何出现在他们6N-Mises应力准则。另一方面,对于研究在脆性材料断裂,使用最大主应力的理论被提出。故障模式将在下面的章节提出。
ENGELMAIER扴破坏模式
在电力电子封装过程中,其中焊点故障的主要机制之一是环状热机械疲劳[5]。有文献报道预测焊点可靠性的各种型号。第一个疲劳损伤模型,给出莫罗。棺材曼森提出了一种基于莫罗抯工作疲劳模型。虽然他的模式似乎提供了一个良好的分析,它已经由Engelmaier解决一些不足。其缺点是主要未能捕捉像循环频率,焊料和基板温度,和铅刚度参数之间的关系。
Engelmaier抯失效模型的输入包括:(1)平均焊点塑性应变,(2)热循环停留时间;(3)焊锡平均温度。模型方程如下。基于由肖汉,P,奥斯特曼,M.,李S.W.R.和Pecht,M.报道加速测试结果CALCE模式曲线获得了SAC305焊锡常数[5,6]。
NF(50%)=0.5times;(0.480/ A D)M
1 / M= CO CI TSJ LN(1 至/把)
1 / M=0.390 9.3*10-4 TSJ - 1.92*10-2 LN(1 100 / TD)
AD - 塑性应变,T0 - 停留时间,TSJ - 平均焊接温度
电力电子放大器将经历基于应用条件的功率周期。基于从制造商提供的信息,它被确定的热循环将开始在室温下,上升至峰值温度(gt; 100癈)中的时间(1或2分钟)短的跨度和在该温度下保持恒定时间(停留)的指定期间,依次循环,在温度下降到室温的末尾。该周期将重复,直到电力电子装置被关闭(室温)。为了预测焊料可靠性,输入至故障模式将是一个单一的热循环的停留时间。 596分钟,20分钟到1分钟周期的停留时间被认为是这项研究。的平均无故障时间。
TTF)预测与Weibull分布函数[5,6],其中威布尔PDF格式的平均值给出如下的帮助。这里,n= NF(50%)通过Engelmaier抯模型接收,Y = 0为位置参数且p =3的威布尔PDF格式类似于正态分布的形状参数。
MTTF = y n * T (1 1/p)
Engelmaier抯模型是文学提供的焊料可靠性预测广泛使用的疲劳损伤模型之一。不过,也有许多假设和相关的缺陷[5]。这些措施包括模型适用于某些类型的包装设计,焊点的几何形状,焊锡蠕变,铅焊料CTE失配和硬导线/大规模扩张不匹配的。由于Engelmaier无法抰解决所有的不足之处,如蠕变应变基础的模式,能源和基础损伤模型复杂的模型,应使用。
屈服现象
材料的屈服点被定义为应力 - 应变曲线,其中,机械性能,所施加的负载的条件下,从弹性变为塑性在这一点上。该包由两种类型的材料,其中之一将经历塑性变形,由于热机械负载条件而另一种类型,这将仅变形弹性的。研究在韧性材料(焊锡,铜)失败,VM-米塞斯(HMH标准)或最大剪切(TG标准),得到的现象都可以使用。 TG的标准是失败的预测更为保守的做法,因此,失败的VM-米塞斯的理论进行了审议。另一方面,为脆性材料,用于测定故障的最大主应力的理论。图3是平面应力衰竭位点对这些现象的情节,由实验测试数据韧性的样品和脆性材料[7]获得。
图5 GEN(下午3点),SiC衬底上(100分)
电力电子组成上的100克碳化硅(SiC)的基板(图5)的活性侧的3克氮化镓(GaN)外延层的。理想情况下,完整的包会间连接到通过表面的PCB(印刷电路板)安装就像BGA(球栅阵列)焊接。由于缺乏包装信息(焊料&PCB - 材料和几何形状)的从制造商提供,它被假定衬底基底面积将在与印刷电路板顶表面区域接触完全。为了模拟这种边界条件,人们认为封装基座表面积将在所有方向上完全约束。此外,PCB并没有仿照前面提到的简单和原因。
对于离散的微型接触选项,三种不同的形状被认为是,在图6中显示如下这包括T形,膨松和锥度小的接触几何形状。微型接触高度,顶部和底部的碱宽度是600克1200和300(分别为所有三种情况。
TE CooleTj !
SiC衬底
有限元(FE)模型设置
在本节中,我们会和讨论:(1)考虑CAD模型几何应力分析,(2)所用的材料,(3)网格划分和(4)(热和机械)边界条件应用。在图4的下方所示的CAD模型给出了功率电子封装的概述。
图3平面应力衰竭位点3标准[6]
在TE冷却器用作热泵,冷却现象是基于珀尔帖效应。在TE冷却器的冷却通量(有源面)可以根据通过该迷你接触结构的小区域(微型接触基板),这将集中于热点热通量的耗散集中[2]。 TE冷却器材料堆叠在图7示意性地表示的冷却器被莱尔德技术提供。热电元件是碲化铋(的Bi2Te3)。如在图7的上方示出,一个单一的元素在两个氮化铝(氮化铝)集管之间通过在每一侧的焊料接头夹在中间。为焊接接头,金属铜层沉积在AlN头的表面上。在TE冷却器的真实材料特性是从制造商不可用。因此,适当的假设被做最满意与期望的应用条件相匹配。 TE冷却器材料堆叠的材料性质和尺寸,从提供的数据表在制造商抯网站确定[8]。各种材料的性能的影响[4,9 - 11]构成电力电子组件将在下面的部分中进行讨论。
表1材料属性的输入有限元模型[4,9 - 11,13,17]
|
Materials |
C.T.E. |
Therm. Cond. |
El. Mod. |
Poisson抯 Ratio |
Yield St. |
|
Units |
ppm*K-1 |
Wm-1K-1 |
GPa |
- |
GPa |
|
SiC |
3.7 - 4.3 |
300 |
480 |
0.18 |
0.13 |
|
GaN |
3.2 |
130 |
295 |
0.25 |
- |
|
SAC305 solder |
24 |
65 |
90 |
0.24 |
0.05 |
|
Copper |
16.4 |
400 |
110 |
0.343 |
0.05 - 0.3 |
|
Diamond |
1-2 |
1800 |
1050 |
0.1 |
1-3 |
|
<p 剩余内容已隐藏,支付完成后下载完整资料
资料编号:[151475],资料为PDF文档或Word文档,PDF文档可免费转换为Word </p |
您可能感兴趣的文章
- 饮用水微生物群:一个全面的时空研究,以监测巴黎供水系统的水质外文翻译资料
- 步进电机控制和摩擦模型对复杂机械系统精确定位的影响外文翻译资料
- 具有温湿度控制的开式阴极PEM燃料电池性能的提升外文翻译资料
- 警报定时系统对驾驶员行为的影响:调查驾驶员信任的差异以及根据警报定时对警报的响应外文翻译资料
- 门禁系统的零知识认证解决方案外文翻译资料
- 车辆废气及室外环境中悬浮微粒中有机磷的含量—-个案研究外文翻译资料
- ZigBee协议对城市风力涡轮机的无线监控: 支持应用软件和传感器模块外文翻译资料
- ZigBee系统在医疗保健中提供位置信息和传感器数据传输的方案外文翻译资料
- 基于PLC的模糊控制器在污水处理系统中的应用外文翻译资料
- 光伏并联最大功率点跟踪系统独立应用程序外文翻译资料



